2023年11月29日
高分解能アナライザーを搭載した最新TOF-SIMS装置の稼働開始について
~高感度な成分分布情報の提供で材料表面・界面に関わる課題解決を支援~
【要旨】
当社(以下、「TRC」)は、このたび、高分解能アナライザーを搭載した最新の飛行時間型二次イオン質量分析(Time-Of-Flight Secondary Ion Mass Spectrometry:TOF-SIMS)装置(*1)を導入し、本装置による分析サービスを開始しました。本装置では含有元素組成や化学構造の定性分析能力や、化学成分の空間的な分布の分析能力が大幅に向上しています。高性能な本装置と、TRCで長年培われたTOF-SIMS分析における高度な解析力、前処理技術を組み合わせることで、表面や界面の化学状態に関する、より信頼度の高い分析結果をご提供することができるようになりました。サステナブル社会に欠かせない各種電池の充放電特性に重要な電極被膜の状態、DXを支える情報デバイス中枢の微細積層膜や有機エレクトロニクスデバイスの有機積層膜などの材料表面や界面が関わる広範な分野の研究・開発において、特性や歩留まりの改善のような課題解決に大きく貢献できることが期待されます。
今後も「高度な技術で社会に貢献する」という当社の基本理念に基づき、より一層の技術水準の向上に努めていくと共に、最新の先端分析サービスをいち早く提供し、少しでもお客様の製品開発に役立てるように、今後も最先端分析技術の開発に邁進して参ります。
【背景】
材料の表面は物質の最も外側の部分であり、反応性、導電・絶縁性、帯電性、接着・剥離性、分散・凝集性、吸着性、濡れ性といった様々な物性に対して重要な役割を果たします。例えば、リチウムイオン電池の電極表面に形成される被膜は充放電特性に大きな影響を与えることが知られており、被膜の成分や厚み、それらの変化を明らかにすることで、特性向上の指針を得ることができます。また、スマートフォンなどの先端デバイスには、半導体部品の微細積層膜や有機ELパネルなどの多層構造の部材が広く採用されています。これらの材料の表面や界面の状態は導電性や発光性などに大きく影響を与えます。しかし、材料表面や界面の状態は、空気や水、その他の汚染などにより変化しやすいので、これらの状態を正確に調べ、把握することで、材料の特性や機能を最大限に引き出すことができると考えられます。
【今回の成果の重要性】
新装置と従来装置で得られた質量スペクトル(*2)の比較を図1に示します。新装置では質量分解能 (*3)が大きく向上したことでピークがシャープになり、より精密な質量演算が可能となった結果、定性分析能力が大幅に向上しました(従来比3.5倍)。また、質量の近い物質をより明確に区別できるので、含有元素の組成比を正確に把握することができます。面内分布や深さ方向分布の解析も一層正確に分析することができます。

図1 質量スペクトルの比較(M/ΔM @C4H7+:C4H7+ピークで読み取った質量分解能)
図2には有機ELデバイスに用いられたガラス基板上ITO電極の境界部分の二次イオン像(成分分布)を示しています。従来装置では導電性の大きく異なる材料の境界付近では境界の付近が暗くなるなど成分分布が不明瞭になることがありましたが、高分解能アナライザーを搭載した新装置では境界が明瞭になり、正しい成分分布が得られるようになりました。また、空間分解能は、従来装置の300 nm程度から100 nm程度まで大きく向上しました。
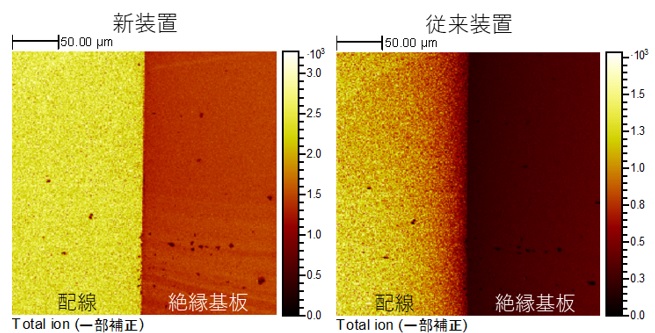
図2 基板上配線部の正二次イオン像の比較
【今後の展望】
今回導入した新型TOF-SIMS装置により、より正確な分析結果を提供できるにようになったほか、これまで分析自体が困難であった導電物-絶縁物境界近傍などについても分析が可能となりました。これらの利点から、局所領域での極表面・薄層の組成把握による材料・デバイス開発支援、微小異物発生源特定によるトラブル解決などにおいて、より有力なツールとなることが期待されます。また、同装置はEDR(Extended Dynamic range)(*4)という機能も備えています。これは非常に少ない量の成分を正確に検出・定量するための機能であり、半導体分野で重要な微量不純物分析に有効です。
今後も「高度な技術で社会に貢献する」という当社の基本理念に基づき、より一層の技術水準の向上に努めていくと共に、最新の先端分析サービスをいち早く提供し、少しでもお客様の製品開発に役立てるように、今後も最先端分析技術の開発に邁進して参ります。
【用語の説明】
(*1) TOF-SIMS:材料表面の状態を調べるための装置。試料表面に加速したイオン(一次イオン)を照射し、その表面から飛び出すイオン(二次イオン)を分析することで、試料表面の構成成分や成分分布に関する情報を得ることができます。TOF-SIMSでは元素だけでなく、有機成分の化学構造情報を高感度に取得できるため、様々な材料に適用可能です。また、表面からのエッチングによる深さ方向分析も可能です。さらに、試料量が微量でも分析可能なので、貴重な試料にも適用可能です。
(*2)質量スペクトル:原子や分子の持つ質量を測定する方法を質量分析と呼び、その結果を示したスペクトルを質量スペクトルと呼びます。
(*3)質量分解能(M/ΔM):異なる質量を持つ2つのイオンを区別する、質量分析計の能力を示す指標です。
(*4)EDR(ダイナミックレンジ拡張):一度に検出できる最大イオンの個数を100倍まで改善できる機能です。その結果、非常に少ない量の成分の正確な検出・定量が可能となります。
【本サービスに関するお問い合わせ先】
所属部署:表面科学研究部表面科学第1研究室 担当者名:白倉大地
TEL: 077-510-9108
E-mail: daichi.shirakura.c9[a]trc.toray
*: [a]は@に置き換えてください。