2023年11月6日
最先端プラズマ集束イオンビーム走査電子顕微鏡の国内分析企業初導入と稼働について
~広域・高精細な電子顕微鏡観察により、製品開発・課題解決をサポート~
【要旨】
当社(以下、「TRC」)は、このたび、最先端のマルチイオン種プラズマ集束イオンビーム走査電子顕微鏡(FIB※1-SEM※2)であるHelios 5 Hydra(Thermo Fisher Scientific製)を、受託分析会社としては日本で初めて自社導入し、受託サービスを開始しました。
プラズマFIB-SEMとは、プラズマを用いて高い電流量のイオンビームを発生させ、試料を加工したり、観察ができる装置です。従来の液体金属を用いたFIB-SEMよりも、広域で高精細なSEM観察が可能になります。また、イオンの種類を切り替えることができるので、試料の種類や目的に合わせて最適なイオンを選び、ダメージや加工ムラを抑えた観察を行うことができます。半導体デバイスやリチウムイオン電池のようなエネルギー関連材料などの微細構造を精密に把握でき、例えば電気的絶縁不良のような不具合の原因究明や品質向上、製品の歩留まり改善に寄与できます。また、TRCが保有するTOF-SIMS※3などの他の分析装置との組み合わせにより、化学組成や化学構造も同時に解析できます。今回新たに獲得した前処理・加工技術とTRCがこれまで培ってきた高度な観察、分析技術と組み合わせることで、特定分野に留まることのない広範なニーズにお応えできます。
今後も「高度な技術で社会に貢献する」という当社の基本理念に基づき、よりいっそうの技術水準の向上に努めていくとともに、最新の先端分析サービスをいち早く提供し、少しでもお客様の製品開発・課題解決に役立てるように、最先端分析技術の開発に邁進してまいります。
【背景】
FIBは集束したイオンビームを試料に照射し、表面の原子を弾き飛ばすことで試料を削ることができるだけでなく、ガスを吹き付けながらイオンビームを照射し、分解堆積されたガス成分で蒸着することも可能な装置です。また、FIBとSEMが組み合わさったFIB-SEMは、FIBで加工した断面をSEMで観察することができます。例えば、①SEMで局所を確認しながらその断面を加工して観察したり、②より微細な領域を観察するために透過電子顕微鏡(TEM) ※4用の薄膜試料を作製したり、③断面加工と観察を繰り返して試料構造を立体的に観察することができます。FIB-SEMは、今までGa(ガリウム)という液体金属のイオンを用いてきました。Gaは液体金属で融点が低く、点状に絞れることなどからFIBに適していると考えられていましたが、ビーム強度が弱く広範囲や硬い物質の加工に時間を要するという問題がありました。
【今回の装置導入の重要性】
加工領域は主にイオンの数(電流)で決まるため、Gaイオンでは実現できない大電流を利用できるプラズマFIB-SEMはより広い範囲(同じ加工時間であれば従来比約8倍の面積)での断面加工が可能です。さらに、TRCが導入したプラズマFIB-SEM はイオンの種類を変えることができるので、物質の種類や目的に合わせて最適なイオンを選ぶことができます。例えば、加工している途中で特定のイオンで加工しにくい物質が存在したら、別のイオンに変えて加工を続けることができます。これにより、平滑な断面に加工できるので、高精細な観察を行うことができます。
図1には、リチウムイオン電池のグラファイト負極をプラズマFIB-SEMを用いて加工したSEM写真を示しています。写真内の白枠は従来のFIB-SEMで長い時間をかけて加工して得られる領域ですが、それに比べてプラズマFIB-SEMは従来よりも広い領域を短時間で加工することができるため、観察場所の選択性が増えてより多くの情報を取得することが可能です。図2には、Xe、Ar、Oの各イオンを用いて加工した際のSEM写真を示します。何れのイオンでも同程度の強さ(電流)で加工していますが、Xeでは含まれる材料の削れやすさの違いによって縦の筋が入り、きれいな加工ができていませんが、ArやOイオンで加工した場合は、加工部が平らになっており、きれいに加工できていることがわかります。

図1 グラファイト負極の断面SEM写真
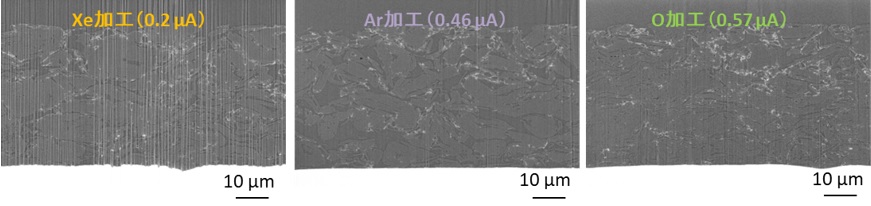
図2 グラファイト負極の断面SEM写真 加工イオン種による比較
【今後の展望】
今回新たに導入したプラズマFIB-SEMでは、Gaイオンを用いた従来装置よりも、広い範囲を高精細に加工し観察することが可能となりました。また、物質の種類や目的に合わせて最適なイオンを選べます。プラズマFIB-SEMは、半導体、エネルギー関連デバイス、ライフサイエンスなど様々な分野で役立ちます。物質の構造や形の把握は、性能や品質を向上させたり、故障の原因を探したりできることに繋がります。物質に合わせてイオンを変えると、物質の構造を壊さずに、もっと詳細に観察したり、分析することができます。これにより、物質の特徴や働きをよく深く理解できることに繋がります。
なお、本装置は、TRCの「先端分析装置 機器利用サービス」(https://www.toray-research.co.jp/taap/equipment_use.html)にも加わる予定です。TRCの専門スタッフによる支援のもと、自社保有が難しいハイエンド装置を自ら試してみたいというお客様ニーズにも応え、お客様の製品開発、課題解決に貢献してまいります。
【用語の説明】
※1)集束イオンビーム(Focused Ion Beam、FIB)
イオンビームを微小径に集束し、試料に照射することで試料表面の原子を弾き飛ばし加工する装置。原料ガスを分解して局所に堆積させることや、イオン照射によって試料から放出する二次電子を検出して観察を行うこともできるため微細加工にも利用される。
※2)走査電子顕微鏡(Scanning Electron Microscope、SEM)
電子線を微小径に集束し、試料に照射する際、この入射電子ビームを試料上で走査させ、試料から放出される二次電子あるいは反射電子を検出して試料の表面形状を可視化する装置。
※3) 飛行時間型二次イオン質量分析(Time of Flight Secondary Ion Mass Spectrometry、TOF-SIMS)
表面に特化した質量分析法で、表面に敏感なため表面汚染物の定性や表面化学構造の解析に用いられる。また、1μm程度の分解能でのイメージングにより成分の分布を画像化することができる。
※4)透過電子顕微鏡(Transmission Electron Microscope、TEM)
薄片化した試料に電子線を照射し、薄片を透過した電子の干渉像を得ることで、物質を原子レベルまで拡大して観察することができる装置。
【本サービスのお問い合わせ先】
本プレスリリースの内容に関するお問い合わせは、下記にお願いいたします。
株式会社東レリサーチセンター
形態科学研究部形態科学第3研究室 担当:高橋和巳
TEL:077-510-9112
E-mail:kazumi.takahashi.r9[a]trc.toray
*: [a]は@に置き換えてください。