2024年3月11日
電子スピン共鳴法を用いて極薄絶縁膜中の膜厚方向の欠陥分布評価を実現
~電気特性向上のための指針獲得により、先端半導体製造プロセス開発を加速~
【要旨】
当社(以下、「TRC」)は、このたび、材料中の欠陥を検出可能な電子スピン共鳴法(ESR法) ※1)を用いて、ロジック半導体やメモリデバイスのような先端半導体デバイスに用いられる絶縁材料(窒化シリコンなど)中の電子を捕獲する欠陥について、実際の先端半導体デバイスで用いられるnmレベルの極薄膜で検出し、膜厚方向で定量化する分析技術を確立しました。先端半導体デバイスの開発競争が激化する中で、TRCは本分析技術により、欠陥を制御する半導体製造プロセス開発を加速し、先端半導体デバイスの高性能化と製造プロセス開発期間の短縮に貢献していきます。
生成AIなどのデータ活用を推進するデジタルトランスフォーメーション(DX)の急速な発達・普及により、先端半導体デバイスはますます需要が増しており、世界各地で開発が進められています。先端半導体デバイスに使用される絶縁材料中には欠陥が存在し、絶縁性やチャージトラップ性能※2)等の電気特性に影響を与えます。製造プロセス開発では、これら欠陥を制御することが重要ですが、ESR法では薄膜中の欠陥を検出して定量化することで、欠陥制御の指針を与えることが可能です。
今後も、長年培ったESR分析の経験と知識を駆使し、さらなる分析技術開発を進め、半導体だけなく、電池材料や医薬品材料等の開発にも貢献していきます。
【背景】
半導体デバイスは微細化・細線化が進み、極薄膜の絶縁材料が用いられるようになっています。しかし、絶縁材料には電子を捕獲する欠陥が含まれており、極薄膜になると、電気特性の低下(漏れ電流量の増加など)という悪影響を及ぼします。そのため、欠陥の種類や量を調べることは製造プロセスの改善に不可欠です。これまでは、極薄膜の欠陥を直接検出し、定量化することができる手法はありませんでした。そこで、TRCではESR法を改良し、極薄膜の欠陥を高感度で検出し、膜厚方向で定量的に測定する手法を確立しました。ESR法とは、欠陥由来の不対電子がマイクロ波を吸収することを利用した分析手法です。金属材料を除く有機材料や無機材料に適用でき、半導体や電子部品、電池や触媒などの機能性材料、高分子やセラミックスなどの素材、医薬品関係など、幅広い分野で活用できます。
【今回の技術確立の重要性】
膜厚が薄くなると、膜中の欠陥量も減少するため、微弱な信号を検出することが必要となります。また、薄膜由来の微弱な信号は製膜基板由来の大きな信号に隠れてしまうため、これらの信号を分離する解析技術が必要となります。TRCはこれらの課題を解決し、先端デバイスで使用されるnmレベルの厚みの絶縁膜に対して、ESR法を用いて欠陥種の同定と欠陥量を定量することを可能にしました。さらに、本分析技術と TRCが長年の受託分析の経験を通して培った高度前処理技術(薬液処理:後述)を組み合わせることで、これまで困難であった極薄膜中の膜厚方向の欠陥量分布評価が可能となりました。
図1(a)にシリコン基板上に原子層堆積法(ALD)※3)で製膜した膜厚2 nmの窒化シリコン膜のESRスペクトルを示します。縦軸から材料中の欠陥量を、横軸の位置から欠陥種を推定することが可能です。図中の上の青色の曲線では、基板由来の大きな信号とシリコン窒化膜由来の小さな信号が重なり合っていますが、独自の解析技術によって、下のオレンジ色の曲線のように、窒化シリコン膜の信号のみを分離することができます。信号の現れる位置から、この信号は模式図に示したように、窒化シリコン膜中に存在する結合が切れた部分に由来するものであることがわかります。
さらに、図1 (b)のように、薬液処理で極薄膜を徐々に薄くする前処理と、ESR測定を繰り返すことで膜厚方向の欠陥分析が可能となります。
図1 (c)に膜厚18 nmの窒化シリコン膜の膜厚方向の欠陥量の分布を示しました。nmレベルの膜厚で欠陥量およびその膜厚方向の分布を測定できるため、実デバイスにより近い状態で分析することが可能となりました。
このように、本手法は、より薄膜化が進む半導体分野での強力な分析ツールになります。温度などの製膜プロセスパラメータと膜中の欠陥量の相関関係を把握することで、先端半導体デバイスの高性能化及び製造プロセス開発期間の短縮に寄与できることも期待されます。
【今後の展開】
ESRと相補的な知見が得られる他の分析手法(赤外分光法※4)、X線反射率法※5)など)と組み合わせた総合解析により、より精度の高い分析結果や現象に対する深い考察をご提供できるよう、引き続き、研鑽を進めてまいります。
TRC は、「高度な技術で社会に貢献する」という基本理念のもと、最先端の分析技術をいち早く提供し、お客様の新製品・新技術創出や製品・製造トラブルに対する高度分析による課題解決支援により、社会全体のサステナビリティ実現に貢献してまいります。
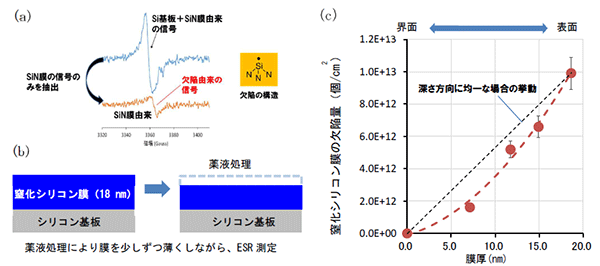
図1 (a)窒化シリコン膜(膜厚:2 nm)のESRデータ:SiN膜の信号のみ抽出前(上)、抽出後(下) (b)ESR法と薬液前処理を組み合わせた深さ方向の欠陥評価方法 (c)窒化シリコン膜(膜厚:18 nm)中欠陥量の膜厚に対する変化
【用語説明】
※1)電子スピン共鳴法(ESR)Electron Spin Resonance:
欠陥がマイクロ波を吸収することを利用し、欠陥の種類や量を測定する手法です。遷移金属イオン、欠陥、有機・高分子の遊離基、活性酸素などの同定、定量が可能です。
※2)チャージトラップ性能:半導体中の電荷が捕捉される能力のこと。半導体中の欠陥や不純物によって電荷が捕捉され、電荷の移動を妨げることがあり、トラップされた電荷が多いほど、半導体の電気特性が悪くなります。一方、メモリでは、この性質をデータを記憶するために用いています。
※3)原子層堆積法(ALD)Atomic Layer Deposition:
原子層レベルで膜厚を制御して平坦で緻密な薄膜を形成する製膜手法。
※4)赤外分光法(FT-IR)Fourier Transform Infrared Spectroscopy:
物質に赤外線を照射し、光の吸収を調べることで、材料の構造解析を行う分析手法。薄膜では、膜の化学結合状態が評価可能です。
※5)X線反射率法(XRR)X-Ray Reflectivity:
X線を試料表面すれすれで入射させたときの入射角に対する反射率を測定・解析することで、薄膜の厚さ・密度・ラフネスを求める分析手法。
【本サービスのお問い合わせ先】
本プレスリリースの内容に関するお問い合わせは、下記にお願いいたします。
構造化学研究部構造化学第1研究室 担当:沢井 隆利
TEL: 077-510-9106
E-mail:takatoshi.sawai.c2[a]trc.toray
*: [a]は@に置き換えてください。