2023年9月25日
Cr線源搭載の最新XPSによる受託分析サービス開始について
~先端半導体表面の組成・化学状態に関して、更に多彩な情報のご提供が可能に~
【要旨】
当社(以下、「TRC」)は、このたび、Cr線源を搭載した最新のX線光電子分光(X-Ray Photoelectron Spectroscopy:XPS)装置であるPHI GENESIS(アルバック・ファイ社製)を導入し、本装置による分析サービスを国内受託分析機関として初めて開始しました。本装置は従来からのAl線源だけではなく、単色化したCr線源による従来比3倍の深さを変えた表面分析が可能 であり、nmオーダーの微細構造を持つ先端半導体の積層膜に対して深さ方向に多彩な表面分析がご提案できます。
現在、情報処理量の増加や移動通信技術の高速化を目指して日々開発が進められているパソコンやタブレット、スマートフォン、ディスプレイなどの中枢の半導体部品は積層構造であり、その層構成や積層膜界面の組成や化学状態(元素の価数や結合状態)のわずかな変化がデバイス性能に大きく影響を与えます。本分析により、次世代デバイスの研究・開発や課題解決に大きく貢献できることが期待されます。
TRCは、「高度な技術で社会に貢献する」という基本理念のもと、最先端の分析技術をいち早く提供し、お客様の新製品・新技術創出や製品・製造トラブルに対する高度分析による課題解決支援により、社会全体のサステナビリティ実現に貢献してまいります。
【背景】
XPSとは、光を試料表面に当てた時に発生する光電子を検出する分光法の一種であり、プローブとしてX線を用いることが特徴です。このXPSは、1960年代にウプサラ大学(スウェーデン)のKai Siegbahn教授のグループが詳細な研究成果を報告して以降、現在まで発展を遂げてきた分析手法で、彼らはこの手法をESCA(Electron Spectroscopy for Chemical Analysis:XPSの別称)と名付け、物質最表面の元素の同定解析に加えて、化学シフトによる元素の結合状態や官能基の評価ができることを示し、現在では代表的な表面分析の一つとなっています。
TRC(1978年設立)においては、その前身の一つである東レ株式会社中央研究所・物性研究室時代の1974年に、AEI(Associated Electrical Industries)・国際電気社製ES-200を導入してから総計9台のXPS装置を保有し、多くの受託分析の経験とともに、最新のXPSの技術開発を継続的に進めてまいりました。今回導入を行ったCr線源(光エネルギー:5.4 KeV)のような通常のAl線源(光エネルギー:1.5 KeV)に比べてエネルギーの高いX線を用いたXPS(HAXPES:Hard X-ray Photoelectron Spectroscopy)については、2000年代からSPring-8などの高輝度シンクロトロン放射光施設を利用した研究を進めてまいりました。同時に、ラボ装置によるHAXPESの技術検討も進めてきた中で、PHI GENESIS導入により、弊社ラボでの受託分析が可能となりました。
【導入装置の適用事例】
先端半導体への適用事例として、シリコン基板上に形成した半導体積層膜にCr線源XPSを用いて測定を行ったSi1s軌道*1のスペクトルを図1に示しました。このスペクトルにおいてシリコン基板由来のSi0成分が検出されており、Cr線源XPSにより積層膜全体の情報が得られていることが分かります。また、Si1sスペクトルの化学シフトの解析より、Al2O3層より下にあるSiO2層とSiN層の情報も明瞭に検出されており、非破壊分析で従来のAl線源では得られない深い領域の積層膜の化学結合状態が得られることが実証されました。
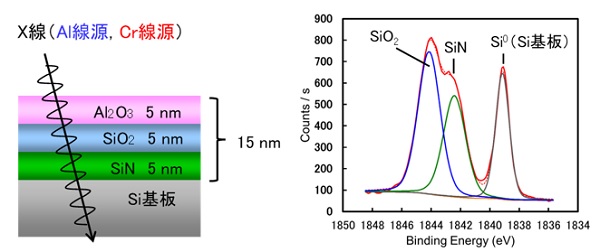
図1 . 半導体積層膜の構造(左)とCr線源XPSによるSi1sスペクトル(右)
また、表1にAl線源およびCr線源のXPSによる半導体積層膜の元素組成の定量結果を示しました。シリコン基板側の表面から深い領域にあるN濃度について、Al線源では僅か数 atomic%であるのに対し、Cr線源では10 atomic%程度と積層膜の構造を反映した濃度の元素組成が得られています。また、Al線源においては最表層にある有機系汚染のC濃度やAl2O3層由来の表面側にある元素濃度が相対的に高くなる一方、Cr線源では検出深さが深いため、C濃度が低く汚染の影響を低減できる効果も確認されました。このように、XPSの線源を使い分けることにより、例えば、材料の表面処理の解析やトラブルなどで10 nm程度の極表層の汚染や付着物に着目するのであればAl線源によるXPS分析を、また、本積層膜の事例のように、30 nm程度までの元素組成や化学結合状態に着目するのであればCr線源によるXPS分析をご活用いただくなど、目的に応じた表面分析をご提案することができます。
表1 . Al線源およびCr線源のXPSにおける半導体積層膜の元素組成(atomic%)
【今後の展開】
本分析とTRCが長年の受託分析の経験を通して保有した各種材料に対する高度前処理技術を組み合わせることで、これまで困難であった半導体の多層積層膜のような複雑な構成を持つ試料において、nmオーダーの特定の層およびその界面の化学状態解析が可能となり、先端半導体の研究・開発にさらに貢献できることが期待されます。また、XPSと相補的な知見が得られる他の分析手法(FT-IR*2, TOF-SIMS*3など)と組合せた総合解析により、より精度の高い分析結果や現象に対する深い考察をご提供できるよう、引き続き、研鑽を進めてまいります。
TRCは、「高度な技術で社会に貢献する」という基本理念のもと、最先端の分析技術をいち早く提供し、お客様の新製品・新技術創出や製品・製造トラブルに対する高度分析による課題解決支援により、社会全体のサステナビリティ実現に貢献してまいります。
【本サービスのお問い合わせ先】
本プレスリリースの内容に関するお問い合わせは、下記にお願いいたします。
株式会社東レリサーチセンター
表面科学研究部 担当:宮田 洋明/安居 麻美
TEL:077-510-9109
E-mail:hiroaki.miyata.p4[a]trc.toray, asami.yasui.c3[a]trc.toray
*: [a]は@に置き換えてください。
【用語説明】
*1 1s軌道:原子は中心に原子核があり、その周りを電子が回っていると考えられている。電子は原子核から離れるほどエネルギーが高くなり、エネルギーに応じて幾つかの層に分かれている。一番内側の層がK殻であり、1s軌道はそのK殻に入る事のできる最大2個の電子の軌道のことであり、元素の性質に強く影響している。
*2 FT-IR:Fourier Transform- Infrared Spectroscopy(フーリエ変換赤外分光法)。測定対象の物質に赤外線を照射し、赤外線吸収スペクトルを利用して化合物を定性する分光法の一種。対象物の化学構造や結合状態を知るために使用される。
*3 TOF-SIMS:Time of Flight Secondary Ion Mass Spectrometry(飛行時間型二次イオン質量分析)。表面に特化した質量分析法で、XPSよりも表面に敏感なため表面汚染物の定性や表面化学構造の解析に用いられる。また、1μm程度の分解能でのイメージングにより成分の分布を画像化することもできる。