2016年12月28日
東レリサーチセンター
組成と不純物の深さ方向分布を同時取得可能な新手法(SIMS-OES)の開発について
【要旨】
株式会社東レリサーチセンター(所在地:東京都中央区日本橋本町一丁目1番1号、社長:川村邦昭)は、組成と不純物の深さ方向分布を同時取得可能な手法・装置(SIMS-OES)を新たに開発し、本手法の受託分析サービスを開始しました。
二次イオン質量分析法(Secondary Ion Mass Spectrometry; SIMS)は、固体試料表面にイオンを照射し、スパッタリングにより放出された粒子の内、イオン化したものを質量分析する手法です。主に、半導体材料などの不純物評価に用いられており、表面分析手法の中では最も高感度であり、深さ方向分布を得ることができるといった特徴を有しています。ただし、主構成元素の定量は原理的に難しく、組成定量評価ができないといった問題がありました。そこで、SIMS分析時にスパッタリングされて放出された粒子の中に、励起されることで原子発光線を生じるものがある事に着目しました。原子発光は元素固有のものであり、発光分光分析(Optical Emission Spectroscopy; OES)することで、構成元素の同定ができます。また、それらの発光線から組成定量を行う技術を開発しました。これにより、イオン照射時にスパッタされ放出したイオンを質量分析(SIMS:不純物評価)しながら、スパッタされた粒子から放出される原子発光線を分光分析(OES:組成評価)することで、不純物と組成の同時評価(SIMS-OES)が可能となりました。
【背景】
イオン(加速イオン束)を試料表面に照射すると、表面および表面近傍の原子は攪拌され、一部が真空中に飛び出します。その際に原子発光が観測されることは、1970年代に発見され、イオン衝撃光照射(Surface Composition by analysis neutral and ion impact radiation; SCANIIR)と呼ばれていました。当時は、イオン衝撃発光強度が弱いために実用化されませんでしたが、感度の高い質量分析器が存在していたため、スパッタイオン(一次イオン)の照射により飛び出してきた粒子の内、二次イオンを質量分析することで、試料中に含まれる成分の定性・定量を行う分析法である二次イオン質量分析法が普及し、現在に至っています。
SIMSは、不純物分析に利用される分析手法であり、濃度既知の試料から得られた強度から相対感度係数を求めることで、評価試料から得られた不純物強度の濃度定量を行うことが可能です。一部、組成定量が可能である系も存在するものの、一般的には組成定量はできません。これは、注目の元素が主成分レベルに達すると、組成が変わることによる感度変化の影響を受けるためです。主成分や注目元素によって異なりますが、注目元素の二次イオン強度と濃度との線形性が保たれなくなるレベルは1%程度です。
また、原子発光を用いた深さ方向分析が可能な手法として、グロー放電原子発光分光法(GD-OES)があります。この手法は、Arプラズマを用いて試料をスパッタし、放出された粒子がプラズマ中で原子発光します。この原子発光を観測することで、深さ方向分析を可能にしています。この度、これらを組み合わせた新しい手法を開発するに至りました。
【技術内容】
装置の構成を図1に示します。SIMS装置(CAMECA社製SIMS4550)の真空窓から光を取り出して、分光分析ができる装置を開発しました。
また、SIMS装置内の配置状況を図2に示します。また、イオンを照射した際の発光状況を、図2と同じ位置から観測した様子を図3に示します。とても広い範囲から粒子の発光が得られていることが確認できます。
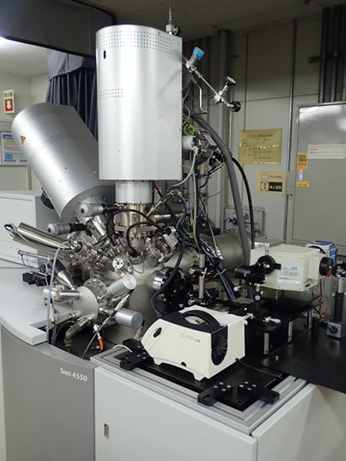
図1 SIMS-OES装置外観
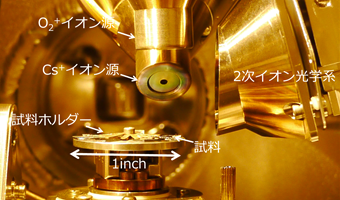
図2 SIMS装置内配置写真

図3 SIMS-OES発光状態
(AlGaInP:O2+イオン, 5keV)
【SIMS-OESによる分析例】
・化合物半導体の組成分析例
InAlGaP系の積層構造を有する試料について、SIMS-OESを用いて定量評価を行った例を図4に示します。組成の深さ方向分布を取得できています。なお、これと同時にSIMSで不純物プロファイルを評価できますので、深さ方向の不純物・組成分布を同時に得ることができます。
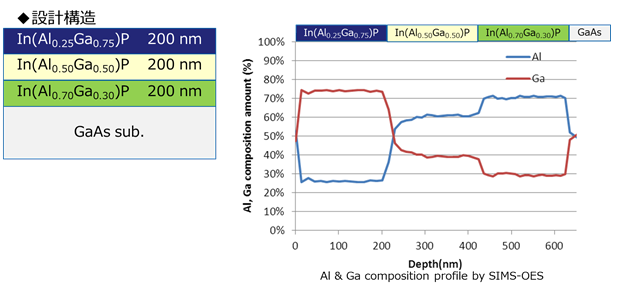
図4 InAlGaP系積層試料構造(設計構造)とSIMS-OESによるAl,Ga組成定量結果
・High-k材料の組成分析例
HfSiOx系の試料において、HfとSiの組成を振った試料について、ラザフォード後方散乱分光法(RBS)の組成定量結果と比較した図を示します(図5)。広い濃度範囲で、HfおよびSiの濃度換算値がよい相関を示すことが確認できます。
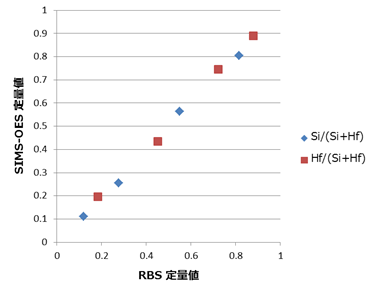
図5 HfSiOx薄膜の組成定量結果比較(RBS vs. SIMS-OES)
【サービスの特徴やメリット】
下記に新しく提供するサービスの特徴やメリットを示します。
・不純物と組成プロファイルを一度に取得することができます。
・SIMSと同程度の深さ方向分解能(nmオーダー)で組成定量が可能です。
・同時に測定ができるため、これまで不純物分析と組成分析を別手法で評価していたものが、1手法で済むことになります。
・組成の定量結果から、適切な標準試料を選択することが可能になります。
【適応例】
本サービスの適応例を下記に示します。
・酸化物半導体、化合物半導体、合金、絶縁物などの材料中不純物と組成の同時評価。
【特許情報】
発明の名称:分析方法およびそれを具備する分析装置
特許番号:特許第5846461
登録日:2015年12月4日
発明者:㈱東レリサーチセンター (宮本隆志、吉川正信)
| 【本サービスの問い合わせ先】 |
株式会社東レリサーチセンター
分析ご相談窓口
E-mail:bunseki.trc.mb@trc.toray |