2024年3月14日
高性能fsLA-ICP-MSによる微量元素の三次元イメージングの受託サービス開始について
-半導体から生体組織まで多様な材料中の微量元素分布可視化で課題解決支援を-
【要旨】
当社(以下、「TRC」)は、高性能フェムト秒レーザー照射型誘導結合プラズマ質量分析装置(fsLA-ICP-MS)※1を用いた微量元素の三次元イメージング技術を開発し、従来技術である二次イオン質量分析(SIMS) ※2では分析が困難だったmm2 ~ cm2の広領域かつppm以下の検出濃度での高感度元素分布可視化の課題を解決し、受託サービスを開始しました。
この技術は、広範 な分野で試料中微量元素の三次元分布を高感度に可視化することができる新技術として期待され、製品開発、製造、品質管理のあらゆる現場で威力を発揮します。製品中の微量元素の三次元の分布状態(拡散、局在、偏在、蓄積など)の解析や存在量の把握が可能となり、製品の品質や性能の向上に貢献できます。例えばライフサイエンス分野では、人間の身体の生体組織中で起こっている数多くの化学反応(酵素反応、抗原 抗体 反応、情報伝達、薬物反応など)において触媒として働き、生命活動を維持する微量元素の分布を調べることで、この微量元素が引き起こす病気のメカニズム解明や生体における薬効評価に貢献できます。
TRCは、今後も「高度な技術で社会に貢献する」という基本理念に基づき、より一層の分析技術水準の向上に努めていくと共に、最新の先端分析サービスをいち早く提供し、少しでもお客様の製品開発に役立てるように、分析技術の開発に邁進してまいります。
【背景】
fsLA-ICP-MSは、フェムト秒レーザー光を固体試料に直接照射し、微粒子(エアロゾル)を発生させてICP-MSで元素分析を行う手法です。フェムト秒レーザーは、試料の熱拡散よりも早い試料表面の蒸発が可能で、発生するエアロゾルが微細化され、従来のナノ秒レーザーによりも、はるかに安定した信号と高い信号強度を得ることができます。また、レーザーの照射条件をコントロールすることで、分析深さを制御できます。
TRCは2020年に高性能のfsLA-ICP-MSを受託分析会社で初めて導入し、微量元素分布の可視化技術の開発に取り組んできました。このたび、試料の深さ方向に二次元イメージング測定を繰り返すことで、「面積:数十 mm2、深さ:数百 nm」領域の三次元イメージ像を構築する技術を開発しました。この技術は、広範な 分野の材料中微量元素の三次元分布を高感度に可視化することができる新技術として期待されます。
【測定事例】
高耐圧、低電力損失、高温安定性等の優れた特性を有し、パワー半導体用材料として期待されているSiCに対して、イオン注入※3によってNiとGeを注入した試料をfsLA-ICP-MSで三次元イメージング分析しました。
図1(a)は、2 mm×5 mmの長方形のエリアについて、深さ方向にNiとGeの二次元イメージング測定を10回繰り返し行い、得られた二次元イメージ像10枚から構築した三次元イメージ像です。ここでは1回の測定で約35 nmの領域を蒸発させることで、表面から約350 nm程度の深さまでの三次元イメージ像を取得しています。両元素ともに二次元の面内(2 mm×5 mmエリア)には均一に存在しており、Niは表面から約100 nm、Geは約200 nmの深さ位置で最も高濃度に分布している結果が得られました。また、Niの注入深さは、最高濃度位置を中心に前後50 nm程度、Geは前後100 nm程度である結果が得られ、Niに比べGeは注入深さが大きいことが確認できました。
この結果は、イオン注入シミュレーション※4によって得られた深さ方向の濃度分布や注入深さ(図1(b))と同様の傾向を示し、ほぼ設計通りの材料ができていることを三次元イメージ像で確認できました。
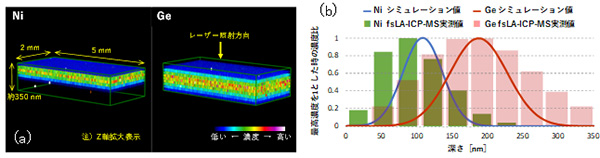
図2 イオン注入SiC基板中の(a) fsLA-ICP-MSによるNiとGeの三次元イメージ像、(b)fsLA-ICP-MS実測値(各深さ測定域の信号強度積算値)とイオン注入シミュレーションによる深さ方向の濃度分布
【今後の展開】
今回、新たに開発したfsLA-ICP-MSによる微量元素の三次元イメージング技術によって、固体試料中の微量元素を高感度で三次元的に分析できます。また、水分を含む生体組織などにも応用できます。TRCは、この技術を駆使し、材料・素材、半導体、ライフサイエンスなど幅広い分野の研究・技術開発を支援します。今後も「高度な技術で社会に貢献する」という当社の基本理念に基づき、より一層の分析技術の向上と、最新の先端分析サービスの提供に努めてまいります。
【用語説明】
※1)フェムト秒レーザー照射型誘導結合プラズマ質量分析
(Femtosecond Laser Ablation-Inductively Coupled Plasma Mass Spectrometry、fsLA-ICP-MS)
フェムト秒レーザーで試料を蒸発させ、その蒸発物を誘導結合プラズマ(ICP)でイオン化し、質量分析器(MS)で元素の種類と量を測定する装置。フェムトとは10-15を意味し、フェムト秒レーザーは、光のパルス幅が10-15秒と非常に短いレーザーで、試料の熱影響を最小限に抑えることが可能。誘導結合プラズマは、高温の電気的に中性なガスの流れで、試料のイオン化効率を高めることができる。また、質量分析器は、イオンの質量と電荷の比によって、元素の種類と量を測定する装置。多元素同時測定が可能で、定量性に優れた高感度な元素分析ができることが特長。
※2)二次イオン質量分析
(Secondary Ion Mass Spectrometry、SIMS)
イオンを固体試料表面に照射し、スパッタリングにより生成した二次イオンを質量分離・検出することで、元素の種類と量を測定する装置。TFO-SIMS(Time of Flight Secondary Ion Mass Spectrometry)は、表面に特化した手法で、表面に敏感なため表面汚染物の定性や表面化学構造の解析に用いられる。NanoSIMSは、SIMSの中で最もビーム径が小さいため、微小領域の微量元素を高い空間分解能で分析することができる。補図(以下)に検出濃度とイメージング領域の比較を示す。
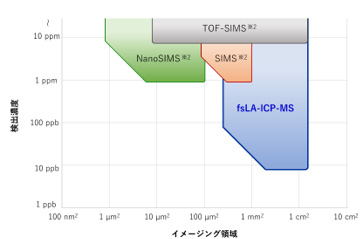
補図 各種微量元素イメージング手法における検出濃度と領域の比較
※3)イオン注入
目的イオンを加速し、固体(基板など)内にイオンを導入する方法。対象材料の電気および光学特性等を制御することができる。
※4)イオン注入シミュレーション
基板組成、基板密度、注入イオンからコンピュータープログラムにより数値計算を行い、イオン分布を数値もしくはグラフで表示させる方法。
【本サービスのお問い合わせ先】
本プレスリリースの内容に関するお問い合わせは、下記にお願いいたします。
株式会社東レリサーチセンター
無機分析化学研究部 担当:藤崎一幸
TEL: 077-510-9116
E-mail:kazuyuki.fujisaki.t3[a]trc.toray
*: [a]は@に置き換えてください。