10/16/2014
No.0222 半導体パッケージ接続部樹脂のFT-IRによる熱劣化評価
近年の電子機器の高機能化・高速化・小型化に伴い、プリント基板の多層化・微細化が進んでいる。高密度実装が進むとチップからの発熱量は増加することになり、半導体パッケージ部材の熱による影響を評価することが重要となってくる。本ポスターでは、半導体パッケージの接続部に着目し、加熱による接続部樹脂組成の熱劣化の影響をFT-IRにより評価を行った結果を紹介する。
測定箇所
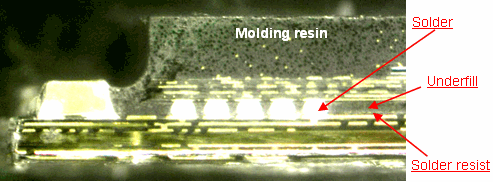
Fig. 1 Cross-section of printed wiring board
測定手法:ATR法
| ATR法とは、試料とプリズムの屈折率の違いによる全反射現象を利用して試料表面の組成情報を測定する手法である。 |
| ・特徴 |
 | 表面感度が高い
非破壊分析 |
| ・測定対象物 |
 | 高分子材料、塗膜、液体、ゴム
プラスチックなど |
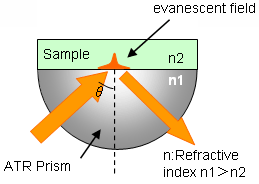
Fig. 2 ATR (Attenuated Total Reflection) principle
アンダーフィルの加熱処理によるFT-IRスペクトルの経時変化
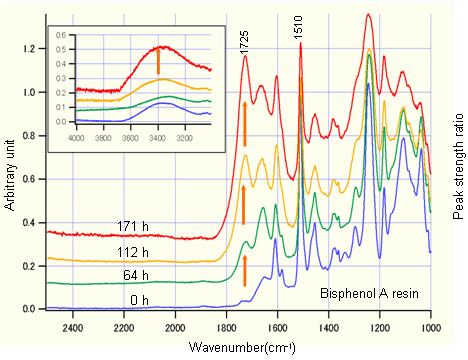
Fig.3 Spectral change vs. heat-treatment time (Temperature: 150℃).
| ・水酸基 |
 | 加熱60時間で減少しているのは分子内の水酸基が脱水しエステルに変化。
加熱時間が長くなるほど水酸基(3400cm-1)が増加。分子鎖の切断にともなう水酸基の増加。 |
| ・エステル |
 | 加熱時間が長くなるほどエステル(1725cm-1)が増加。分子内の酸素の導入。酸過酸化物の生成。 |
|
酸化劣化 |
非破壊で測定できるため、
経時的な構造変化をとらえることが可能 |
ソルダーレジストの冷熱サイクル試験
| Fig.5 | (a) Comparison of spectra obtained before and after heat-cycle examination. |
 | (b) The inset shows difference spectra between treated and initial spectra. |
・処理前後の比較 |
 | 冷熱処理前後でソルダーレジスト表面成分に顕著な差は見られない
⇒差スペクトル法による比較 |
|
 | 酸過酸化物(1770cm-1)、エステル(1730cm-1)が処理後で多い
⇒酸化劣化 |
・深さ方向分析 |
 | 表面からどれくらいの深さまで劣化しているか検証(研磨ATR法) |
|
 | 内層部では酸過酸化物やエステルは生じていない
⇒表面のみ劣化。 |
 |  | 内層部まで酸化されるほどの激しい劣化は生じていない |
深さ方向分析により詳細な解析が可能 |
分析機能と原理
カテゴリー
半導体・実装
分類
実装・パッケージング