09/22/2014
No.0026 SiCエピウエハのナノレベルに至るシームレス欠陥評価
ワイドギャップ半導体であるSiCは、低損失性、高速・高温動作など性能仕様の厳しいパワーデバイス材料として近年盛んに用いられている。しかし、SiCデバイスには様々な開発課題が残されており、特にエピ膜内に存在する結晶欠陥(積層欠陥など)は、デバイス特性に大きな影響を与えている。ここではSiCエピウエハ内に存在する欠陥において、TEM(Transmission Electron Microscope)を用いたナノレベルに至る解析を紹介する。
TEMを用いたナノスケールの結晶欠陥評価
取得したPLイメージから結晶欠陥の位置を同定し、TEMを用いることで、さらに詳細な結晶欠陥評価を行うことが可能である。以下にPL(Photo Luminescence)イメージ(1)と(2)で確認された結晶欠陥について断面TEM観察を用いて解析を行った結果を示す。

図1 PL image(1)

図2 TEM image(1)
図2においては、4H-SiC構造の中に8H-SiC構造が積層欠陥として挿入されていることが確認される。
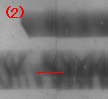
図3 PL image(2)
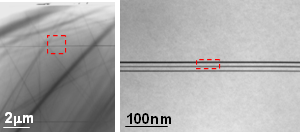
図4 TEM image(2)

図5 TEM image(2)
図5においては、4H-SiC構造の中に3C-SiC構造が積層欠陥として複数箇所挿入されていることが確認される。
分析機能と原理
カテゴリー
半導体・実装
分類
化合物半導体・オプトデバイス