02/03/2021
No.0450 NanoSIMSによるSiC-MOSFET断面の元素分布評価
NanoSIMSは、SIMS(二次イオン質量分析)の中で最も空間分解能が高く、同時に高い感度、高い質量分解能を両立することが可能な装置である。本資料は、SiC-MOSFET断面についてNanoSIMSとTEM-EDXを用いて、元素分布を比較した事例を紹介する。
|
| SiC-MOSFETの分析箇所 |
 |
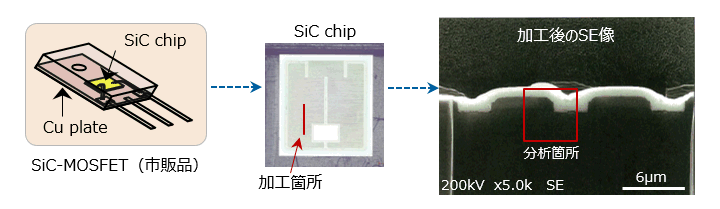
n型のSiC-MOSFET(市販品)をパッケージから開封しチップを取り出した後、電極を除去した。
チップの該当箇所(赤線)についてFIB加工により断面出しを実施した。
|
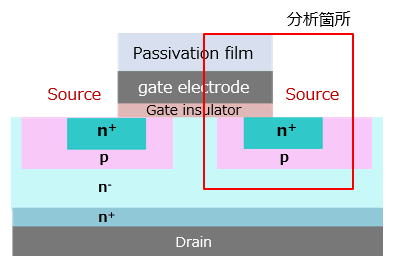 |
| SiC-MOSFETの予想断面構造 |
 |
TEM-EDX, NanoSIMSによるSiC-MOSFETの元素分析
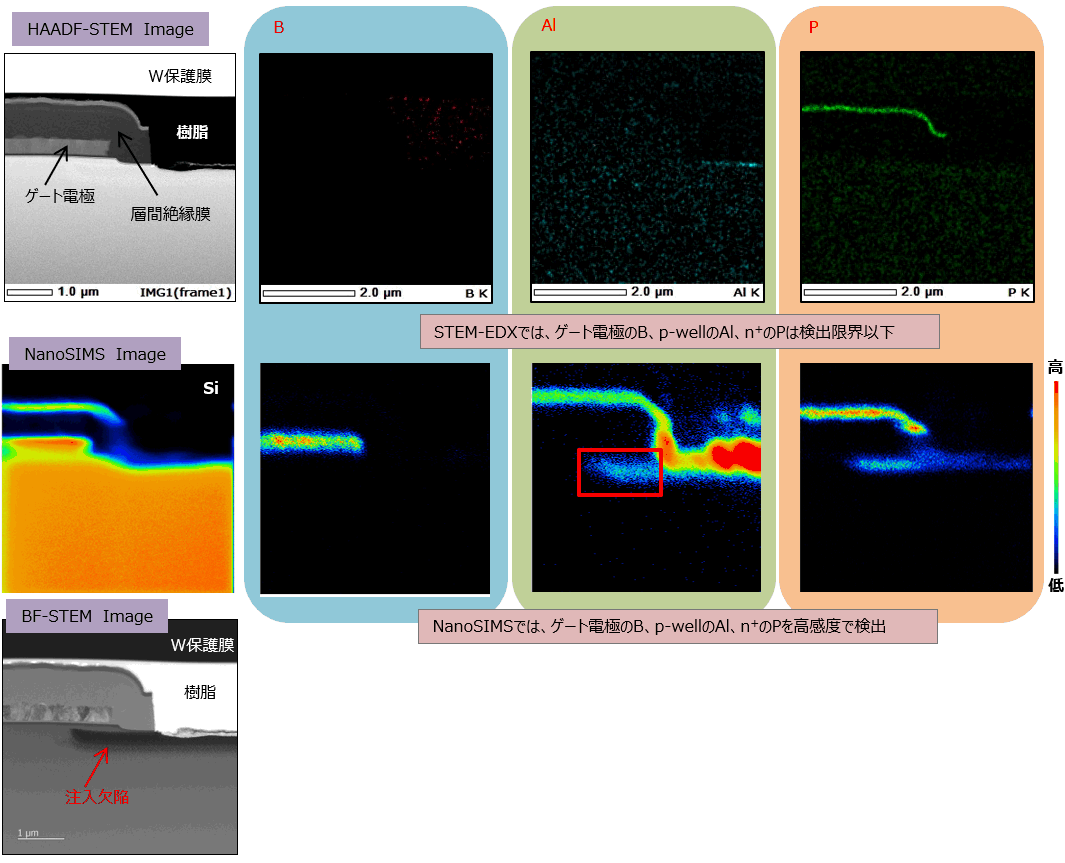 |
TEM-EDXでは、層間絶縁膜(PSG)由来のPや電極汚染由来のAlがわずかに検出されているものの、ゲート電極のB、p-wellのAl、n+領域におけるPは検出限界以下であった。
一方、NanoSIMSでは、これらの領域における各不純物のイメージ像が鮮明に捉えられている。
また、赤枠で示すAlの分布は、下図のBF-STEM像で認められる注入欠陥の形状とよく一致しており、実際にAl分布が表面側にせりあがっている可能性が示唆された。
このように、NanoSIMSは、TEM-EDXでは検出できないドーパント、不純物分布を高感度かつ高空間分解能で評価することが可能である。 |
 |
分析機能と原理
カテゴリー
自動車, 半導体・実装
分類
パワーデバイス・ディスクリートデバイス