10/07/2014
No.0214 Si中Pの極低濃度分析(SIMS)
これまでSIMSでは評価が困難とされてきた極低濃度領域のSi中Pの分析において測定条件の検討を行うことで極低濃度領域の評価が可能となった。
Si中Pの超高感度分析
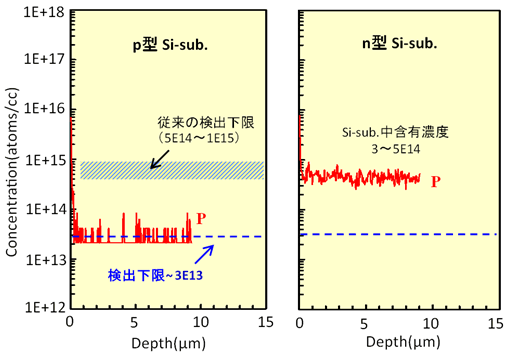
Fig.1 Si-sub.中Pのデプスプロファイル
測定条件の改善により従来よりも大幅に低い検出下限(D.L.~3E13 atoms/cm3)を達成した。それにより、これまで検出が困難だったn型Si-sub.中のP濃度(本試料では3~5E14 atoms/cm3)のような極低濃度のPプロファイルの評価が可能となった。
Si中Pの極低濃度分析における精度
 | Sample A | Sample B |
注入量比 | 1.00 | 1.05 |
イオン注入により作製したPの注入量が5%異なる試料(P注入量A<B)において、上述の測定条件で分析した結果、面密度、Peak濃度ともに約4%の試料間差が得られた。
極低濃度のPの分析においても僅かな試料間差を議論することが可能である。
分析機能と原理
カテゴリー
半導体・実装
分類
LSI・IC・メモリ