カソードルミネッセンス(CL)法を用いた点欠陥評価
カソードルミネッセンス(CL)法により、Si中の結晶欠陥の評価を行うことができる。特に、TEMでは評価が難しい点欠陥の評価に有効である。発光線のエネルギー位置(波長位置)から欠陥の状態についての情報が得られ、強度から欠陥量に関する情報が得られる。
TEM法による結晶欠陥評価
パワーデバイスでは、トレンチ加工時のエッチングダメージや応力起因の結晶欠陥発生、イオン注入プロセスで生じた結晶欠陥などが素子の耐圧不良、オン抵抗の増大等に影響する。このような欠陥評価にはTEM法が有効である。下図は、IGBT中に発生したイオン注入に関係する結晶欠陥の観察例である。発生場所と欠陥の程度から、直ちに電気特性に影響を及ぼすものではないと考えられるが、素子の信頼性を考える上では考慮すべき事象であると考えられる。

IGBT素子エミッタ付近の結晶欠陥の観察例
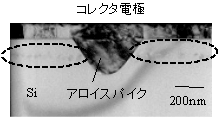
IGBT素子コレクタ付近の結晶欠陥とアロイスパイクの観察例
分析機能と原理
カテゴリー
半導体・実装
分類
パワーデバイス・ディスクリートデバイス