10/16/2014
No.0219 IGBT電気特性と結晶欠陥との関連性評価
一般に、半導体素子中の結晶欠陥は電気特性に大きく影響する。電力変換用に用いられるパワーデバイスでは結晶欠陥の低減あるいは適切な制御は極めて重要である。ここでは、パワーデバイスの中から絶縁ゲートバイポーラトランジスタ(IGBT:Insulated Gate Bipolar Transistor)を取り上げ、電気特性と物理解析(カソードルミネッセンス(CL)法)から得られる結晶欠陥との関連性について評価した事例を紹介する。
パワーデバイスにおける物理解析
| [物理解析ニーズ] | [現象] |
| ・ | 故障(部品組立時の故障、市場故障)解析 | ・ | 接合リーク |
| ・ | 開発・量産試作、各種信頼性試験に伴う解析 | ・ | オン抵抗の増大 |
| ・ | 他社品解析 | ・ | スイッチング特性の低下 |
| ・ | 納入検査(デバイスユーザ) | ・ | 電流増幅率の低下・ばらつき |
 |  | ・ | 耐圧不良 |
 |  | ・ | パッケージング関係の不良 |
[分析項目と手法]
形態観察 | 光顕,SEM,TEM |
キヤリア濃度分布 | SCM/SSRM,SIMS,SR |
基板結晶欠陥応力 | CL,PL,ESR,TEM,ラマン, エッチピット観察 |
表面分析(加工ダメージ等) | TOF-SIMS,AES,CL,ラマン |
電極 | AES,SIMS,RBS,XRD,TEM |
IGBTの構造と電気特性
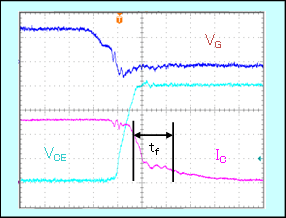
IGBTのスイッチングオフ波形の例
オン電圧とターンオフ時間の変化
項目 | 熱ストレス後 |
コレクタ-エミッタ間飽和電圧 VCES | 87% |
ターンオフ時間 tf | 174% |
IGBTはバイポーラ素子の一種であり、少数キャリア動作素子である。nドリフト層の厚みやキャリア濃度は耐圧を決める重要なパラメータであるが、それら以外にスイッチング特性を決める要因として、キャリアライフタイムが挙げられる。ライフタイム制御には、結晶欠陥や不純物の適切な制御が重要である。
本実験では、600V耐圧の素子について、熱ストレスをかけた後に電気特性を評価した。その結果、オン電圧(VCES)が減少し、ターンオフ時間(tf)が増加した。この特性変化は、Si結晶中のライフタイムキラーとなる欠陥が減少している可能性を示唆している。
カソードルミネッセンス(CL)-電気特性との相関
| 特徴と得られる情報 |
| 1. | 位置の確認が容易(SEM像で確認) |
| 2. | SEM像と対応した発光強度像 |
| 3. | 深さ分析(加速電圧依存性) |
| 4. | 欠陥の種類・状態 |
| 5. | 欠陥のエネルギーレベル |
| 6. | 半定量分析 |
断面加工を行い、CLスペクトル測定を行った。各種格子間(Interstitial)点欠陥(W, X, C線)が観測された。熱ストレスにより、W線が減少しX線が増大した。どちらも格子間Siのクラスターに起因しているが、X線の方がよりクラスターサイズが大きい可能性が指摘されており、熱ストレスによって格子間Si点欠陥の個数が減少し、クラスターサイズがより大きくなったことが示唆される。
素子断面について、W線の強度分布の測定を行った。W線の強度は一様ではなく、nドリフト層で強くなっており、エミッタ近傍p層とp+層では弱くなっている。格子間Si点欠陥の生成には、ドーパント不純物(B)も影響すると考えられる。熱ストレス後には強度だけでなく、分布状態も変化することが分かる。
格子間Siの変化(より疎になりクラスター化する変化)が直接的、あるいは空孔(vacancy)型欠陥との相互作用を通じて、オン電圧の減少とターンオフ時間の増大につながったものと考えられる。
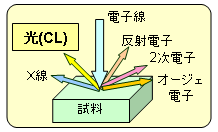
原理
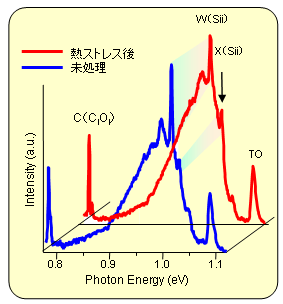
Nドリフト層のCLスペクトル
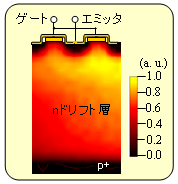
未処理IGBT断面のCL強度像(波長1218nm)
(W線の強度像)
分析機能と原理
カテゴリー
半導体・実装
分類
パワーデバイス・ディスクリートデバイス