09/24/2014
No.0040 MEMS・TSVの先端分析技術
-応力・不純物・汚染評価-
LSIの微細化による高性能化が限界に近づくにつれて、新しいデバイス開発の流れとして、「More than Moore」という概念が注目されている。この概念はMEMSなど様々な機能とCMOSを融合して、新しい機能を創り出すというものである。ここでは「More than Moore」を実現するために必要な三次元積層技術として注目されているTSV(Through Silicon Via)およびMEMS(Micro Electro Mechanical System)の評価技術について紹介する。
TSVの評価技術
TSVにおける評価項目


TSV近傍に発生するSiの応力はその近傍に存在するトランジスターの動作に影響を与える可能性があるため、応力が及ぶ範囲について知見を得ることは重要である。本試料では、角部において約60MPaの引張り応力が観測された。
SIMSによるCu中の不純物評価

TSVのCu中におけるClなどの深さ方向不純物分布やバリア膜のCuバリヤ性について評価が可能である。
市販加速度センサーの評価
静電容量型加速度センサー解体後の形状観察
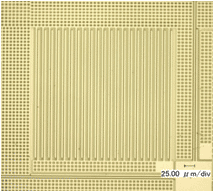
Optical photomicrograph
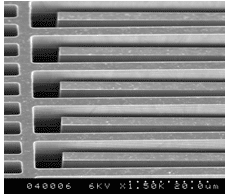
SEM-image
MEMSデバイスは可動部を有していることが特徴であり、可動部を評価するためには、これを保護している封止膜を除去する必要がある。上記写真は市販加速度センサを解体し、センサ部を観察したものである。その形状から、静電容量型の加速度センサであることがわかる。
センサー部表面の付着物評価(正二次イオン像(TOF-SIMS))
MEMSでは可動部がくっついてしまうスティッキングの問題があり、可動部表面の化学状態を知ることは重要である。今回解体した加速度センサーのセンサ部表面ではPDMS(ポリジメチルシロキサン)が検出された。