09/22/2014
No.0010 バックサイドSIMSによるドーパントの拡散評価
デバイス特性を制御するには、ドーパントの分布を正確に知る必要がある。SIMSは微量不純物を分析するのに最適な手法であり、特に裏面側から分析を行うバックサイドSIMSは、試料表面の絶縁膜や配線などの影響を受けることなく分析できるため、実際のデバイス構造に近い状態での評価が可能となる。ここでは、TEGパターンを想定した微小領域における評価事例を紹介する。
バックサイドSIMSの目的
微小部のバックサイドSIMS
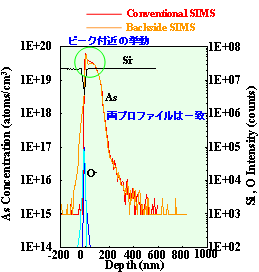
100µm 領域におけるAs分析結果 (表面と裏面からの比較)
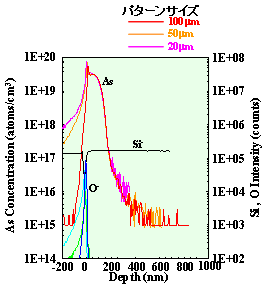
100,50,20µm 領域におけるAs分析結果 (裏面からの分析:バックサイドSIMS)
・ | Si基板中におけるAs分布は、表面・裏面からの両プロファイルは、よく一致する |
・ | Asピーク付近(SiO2膜近傍)の挙動は、バックサイドSIMSの方が明確である |
・ | 20µm□以上の領域が存在すれば、バックサイドSIMSによる評価が可能である |
分析機能と原理
カテゴリー
半導体・実装
分類
LSI・IC・メモリ