顕微ラマン分光法を用いたトレンチゲート構造の応力・歪み評価
過度の応力は、結晶欠陥発生やトランジスタのしきい値変動の原因となる。図1は、ラマン分光法を用いて、トレンチゲート付近の局所応力を評価した例である。Si基板には圧縮側(格子が縮む側)の応力が生じている。また、パワー素子は動作中に発熱し、さらに過酷な環境下で使用されることが多いため、実装・パッケージングにおける応力発生も懸念される。図2は、-40℃~200℃での応力の変化を調べた結果である。エミッタ電極付近で温度依存性が大きくなっている。
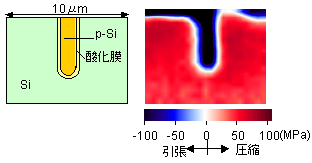
図1 ラマン分光法から求めたトレンチゲート周辺の応力分布
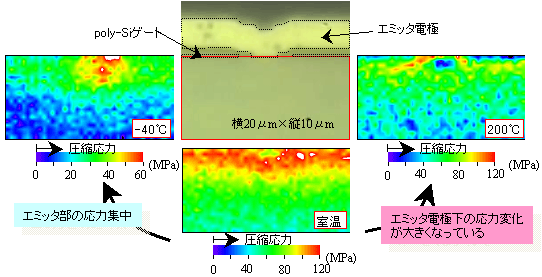
図2 エミッタ付近の応力の温度依存性
分析機能と原理
カテゴリー
半導体・実装
分類
パワーデバイス・ディスクリートデバイス