10/16/2014
No.0220 レーザーアニール後のSi基板中キャリヤ濃度・結晶性評価
近年、ドーパントの活性化に表層のみを処理できるレーザーアニールが注目されている。
しかしながら、アニール後のドーパントの分布・拡散やキャリアとしての活動を阻害する欠陥の回復状況に関し、十分な知見があるとは言い難い。今回、Si基板中にPをイオン注入した試料を用い、異なるレーザーの照射条件でアニールした試料を用いて、ドーパント分布・欠陥の回復状況を評価した結果を紹介する。
n型Si基板中に2種の異なる条件にてPをイオン注入し、3種のアニール条件にて活性化処理を実施。
試料明細
試料 | 注入条件 | レーザーアニール条件 |
No.1 | ① | A |
No.2 | ② | B |
No.3 | ② | C |
SIMS,SRAによるドーパント・キャリア濃度分布
| SIMS: |
 | 表面近傍(~1µm)の繰り返し再現性が低く、面内ばらつきを示唆 |
| SRA: |
 | Sample No.2では、キャリア濃度が低下(抵抗の増大)。
活性化が不十分、キャリアの活動を阻害する欠陥などの存在を示唆。 Sample No.3でも低濃度領域では、同様の可能性あり。 |
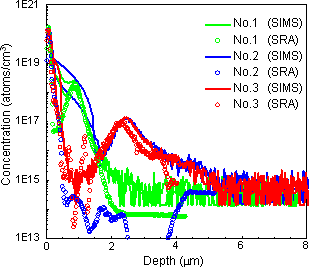
SIMS,SRAによる深さ方向分布
SIMS:P濃度n=2, SRA:n型キャリア濃度
SIMS : 二次イオン質量分析法/Secondary Ion Mass Spectrometry
SRA : 拡がり抵抗測定/Spreading Resistance Analysis
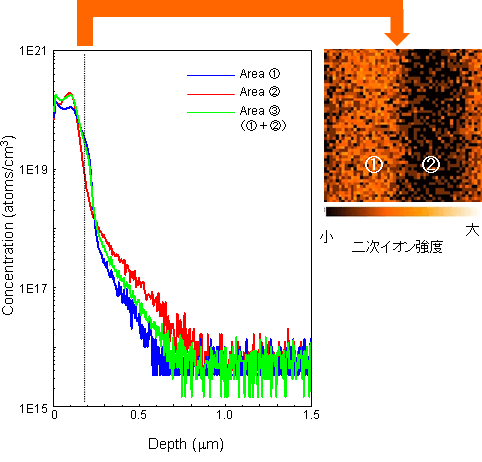
イメージデプスによるP濃度分布(No.2)
右上:深さ約0.2µmにおける面内分布
TEMによる断面観察
| No.1 | : | 欠陥は存在するものの、結晶性は良好。 |
| No.2 | : | 深さ約100nmに欠陥が多い。表面には非晶質層も存在。 |
| No.3 | : | 深部に欠陥あり。 |
 | ⇒ 処理条件により回復状況は大きく異なる。 |
CLによる欠陥評価


・ | 試料間で、欠陥の種類が異なり、格子間Siのクラスターは、No.3が2よりも大きい。
No.1はCに関係した欠陥が存在。 |
・ | 欠陥は、注入領域よりも深部(10µm以上)まで生成する。 |
分析機能と原理
カテゴリー
半導体・実装
分類
パワーデバイス・ディスクリートデバイス