06/11/2015
No.0245 TOF-SIMSを用いた半導体の深さ方向分析
TOF-SIMSはDynamic SIMSにはない特徴を持っており、
(1) サブミクロンの分解能で微小エリアの不純物測定
(2) 高深さ分解能で、かつ質量干渉の影響を受けない薄膜の不純物測定
(3) 薄膜中不純物元素の定性・定量や深さ分析
が可能である。
モード | 検出感度 | 空間分解能 | 深さ分解能 | 質量分解能 | 特徴 |
高空間分解能 | △ | ◎
0.5μm | ◎ | × | 微小領域を
高い深さ分解能で測定可能 |
高質量分解能 | ○
ppm | ○ | ◎ | ◎ | 質量干渉なく
高い深さ分解能で測定可能 |
Table 1 TOF-SIMSによる不純物元素の深さ方向分析の特徴
●SiC-MOSFET(市販品)のパッシベーション膜のデプスプロファイル (高空間分解能モード)
SiC-MOSFET市販品の分析事例である。
二次イオン抽出領域(Fig.1の青色長方形部)は約2μm幅で、他手法では困難な微小領域における不純物の知見が得られる。
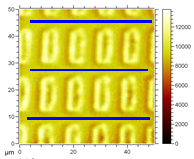
Fig.1 二次イオン像(全元素,50μm□)
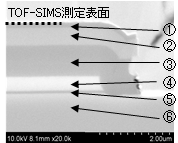
Fig.2 同等箇所の断面SEM像
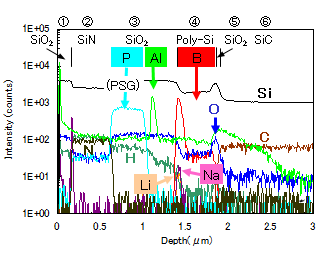
Fig.3 ゲート部のデプスプロファイル (Fig.1青色領域より抽出)
●AlGaN中Si,(F)のデプスプロファイル(高質量分解能モード)
数10nmの薄膜の不純物を他の質量干渉なく、かつ高い深さ分解能で深さ方向分析することが可能である。
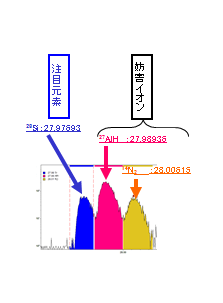
Fig.4 マススペクトル AlGaN中Si, AlH, N2 (m/z=28)
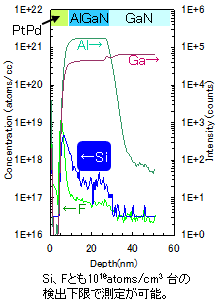
Fig.5 AlGaN中Si及びFの濃度プロファイル
●SiO2/SiCの定性・定量分析(高質量分解能モード)
元素 | 濃度 | 元素 | 濃度 | 元素 | 濃度 | 元素 | 濃度 | 元素 | 濃度 |
Li | <3E15 | Mg | <2E16 | V | <3E15 | Ni | <4E16 | Zr | <4E15 |
Be | <1E17 | Al | 1E17 | Cr | <6E15 | Cu | <4E16 | Mo | <7E16 |
B | 3E17 | K | 3E16 | Mn | <1E16 | Zn | <2E18 |  |  |
N | <5E19 | Ca | <2E16 | Fe | <4E17 | Ga | <2E15 |  |  |
Na | <2E15 | Ti | <4E15 | Co | <4E16 | Y | <2E15 |  |  |
Table.2 SiO
2中の元素濃度 (atoms/cm
3)
Table.2の測定結果から得られた一部の元素のデプスプロファイルをFig.6に示す。
数10nmの薄膜で、多数の元素の定性・定量深さ分析が可能である。
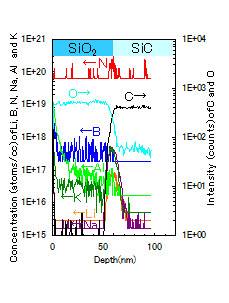
Fig.6 デプスプロファイル
分析機能と原理
カテゴリー
半導体・実装
分類
化合物半導体・オプトデバイス