06/08/2015
No.0238 GCIBエッチングを用いたXPS分析
GCIB(ガスクラスターイオンビーム)は、エッチング時の試料ダメージがきわめて小さいため、従来は正しい結果が得られなかった有機物の深さ方向分析が可能となる。また、無機物表面の有機汚染クリーニング法としても有効である。
●GCIB-XPSの概要とポリイミドの深さ方向分析
|
XPS(X-Ray Photoelectron Spectroscopy)は表面~数 nmの元素組成と化学状態を分析する手法である。イオンエッチングの併用により深さ方向分析も可能であるが、Ar+イオンエッチングをポリイミドなどの有機物に適用した場合、試料損傷が著しく正しい結果が得られない。一方、 GCIBによるエッチングでは、ダメージを低減して分析することが可能である。また、GCIBは無機物に対してのエッチングレートが極めて遅いため、無機物上の有機物汚染のクリーニングとしての活用も期待できる。
|
●GCIB-XPSによるフッ素コーティングしたPET(ポリエチレンテレフタレート)の深さ方向分析
フッ素の深さ方向分布より、フッ素が表面近傍に偏析していることが分かる。また、最表面のC 1sスペクトルより、最表面ではCF2 , CF3 成分#1の炭素が存在していることが分かる。
#1:CF3成分にはO-CF2成分が、CF2成分にはO-CF成分も含まれる。
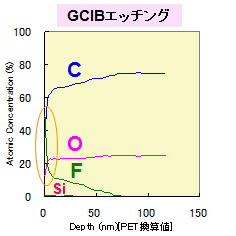
フッ素の深さ方向分布
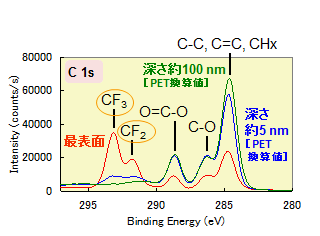
最表面のC 1Sスペクトル
●変色したAgのGCIBエッチングによる表面クリーニング
最表面では、Agの価数を判別するAg MNNオージェピークが汚染の存在により認められない。GCIBエッチングにより汚染を除去した後のAg MNNピーク位置より、Agの状態について、Ag0(金属)成分に加えてAg+(Ag2Sなど)成分の存在が分かる。
※ワイドスキャンスペクトルから、Sの存在が確認されている。
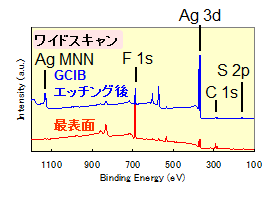
最表面のワイドスキャンスペクトル
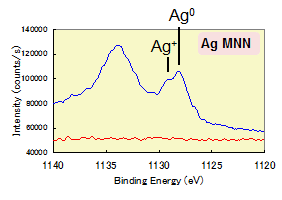
Ag MNNナロースキャンスペクトル
カテゴリー
材料・素材
分類
高分子材料