06/02/2016
No.0303 UV照射ESR測定によるSiN薄膜中の欠陥の定量評価
SiN膜は半導体分野において、保護膜やメモリの電荷蓄積層など、幅広く使用されている絶縁膜である。SiN膜中の欠陥はチャージトラップとなるため、電気特性に影響を与える。ESR分析では、SiN膜にUV照射する事で膜中の欠陥量(=ダングリングボンド量)を定量的に評価する事が可能である。
SiN膜中の欠陥量の評価方法
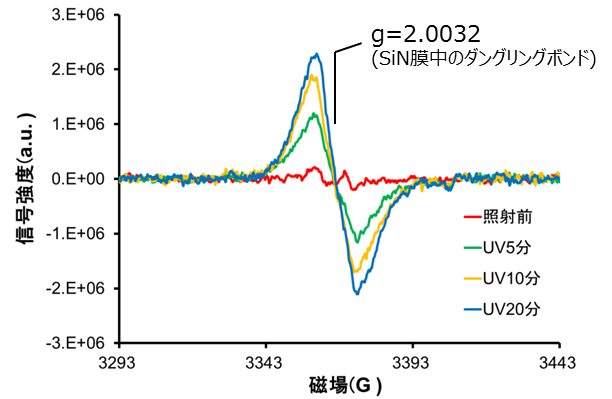
図1 SiN膜(100nm)のESRスペクトル
ESR不活性な欠陥を、ESR活性な欠陥に変換(=活性化)して測定
UV照射時間依存性
図2は、ダングリングボンド量のUV照射時間依存性である。図2より、照射20分までは活性化によりダングリングボンドが増加するが、照射20分以降では若干減少する。この減少はダングリングボンドが膜中のHなどと反応するためと考えられる(文献1)。
⇒ 評価には、適切なUV照射時間(や照度)を考慮する必要がある。
【文献1】W.L. Warren, C.H. Seager, J. Appl. Phys. 77(1995)5730-5735.
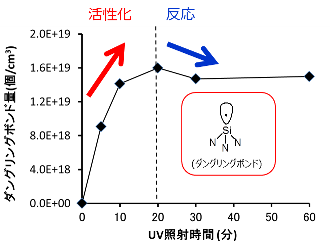
図2 ダングリングボンド量 vs. UV照射時間
SiN, SiON膜のUV照射ESR測定結果
表1. 膜中のダングリングボンドの定量結果
サンプル名 | 成膜方法 | 膜中のダングリングボンド量
(個/cm3) |
P-SiN(20nm) | プラズマCVD | 6.5E+18 |
LP-SiN(20nm) | 低圧プラズマCVD | 6.1E+18 |
P-SiON(50nm) | プラズマCVD | 2.3E+19 |
P-SiON(50nm)
アニール | プラズマCVD,
アニール品 | 1.3E+19 |
10nm程度の薄膜でも評価可能
分析機能と原理
カテゴリー
半導体・実装
分類
電子・機能性材料