03/04/2021
No.0460 水銀プローブCV/IV測定装置(MCV)による電気特性評価
測定方法
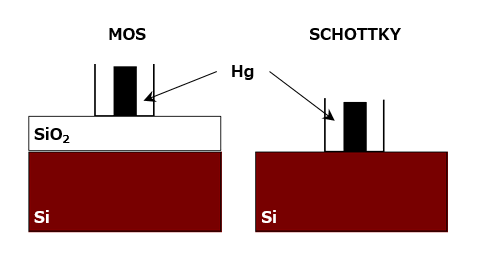 |
半導体シリコンウェーハの電気特性やMOSデバイスの酸化膜等の特性評価が可能。
従来ではウェーハにゲート電極としてPoly-SiやAl等を蒸着し,MOS構造・ショットキー構造形成後にCV/IV特性評価を行う必要があったが、Hg-CV/IV測定装置は装置自身がゲート電極を持つため,メタルゲート作成なしに酸化膜や ウェーハの電気特性を得ることが可能。 |
 |
用途と特徴
用 途 | 特 徴 |
■酸化膜中の電荷の評価 (VFB)
■界面準位測定 (Dit)
■エピ層の抵抗率測定 (ρ)
■低ドース イオン注入の部分的ドース量の評価 (PID)
■ライフタイム測定 (τg)
■高/低 誘電材料の誘電率測定 (ε)
■絶縁膜の信頼性試験 (TZDB, TDDB) | ■水銀プローブにより電極の形成が不要
■測定の再現性に優れている。
ショットキー : 0.3 % (1σ)
MOS : 0.1 % (1σ)
■高精度・高感度
■ウェーハ面内のマッピングが得られる |
 |
| Hgプローブによる試料の界面準位(Dit)測定例 |
 |
Fig.1 C-V Curve (HF & LF) of Sample
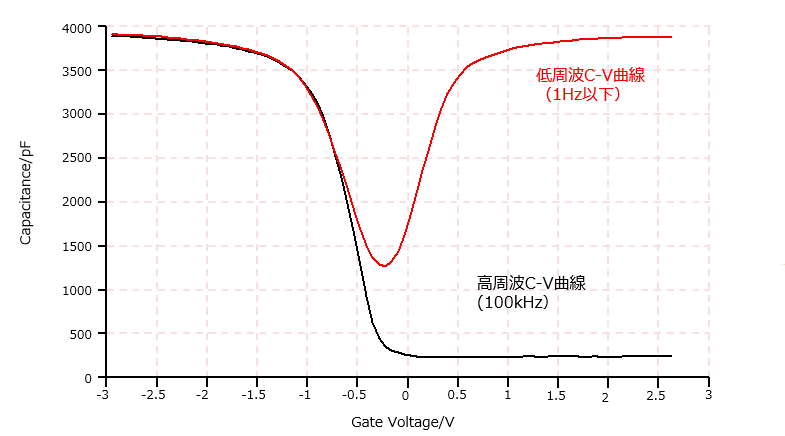 |
|
Fig.2 Dit Curve of Sample
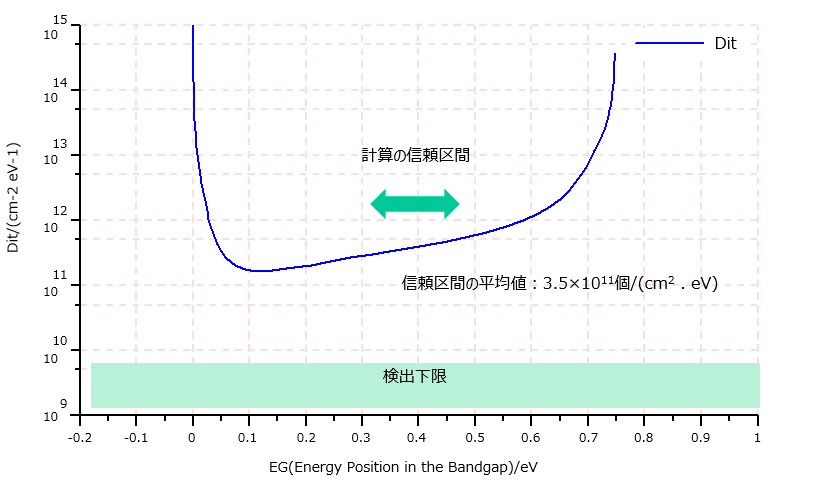
|
| 4インチウェーハ上、厚さ15nmの熱酸化膜とSi基板の界面準位を定量した例を示す。高周波数で測定したC-V曲線と低周波数で測定したC-V曲線の比から界面準位(Dit)の量を計算することができる(Quasistatic C-V method)。 |
 |
カテゴリー
自動車, 電池, IT機器, 材料・素材, 半導体・実装, ライフサイエンス
分類
太陽電池, 電子・機能性材料, LSI・IC・メモリ, パワーデバイス・ディスクリートデバイス, 化合物半導体・オプトデバイス, イオン注入